广东致能报告全球首创硅基垂直GaN HEMT功率器件技术
类型:新闻
时间:2025-07-15
2025年7月10日,广东致能CEO黎子兰博士,在瑞典举办的全球氮化物半导体顶尖会议ICNS(国际氮化物半导体会议)上发表邀请报告,首次报道了广东致能的垂直GaN HEMT功率器件技术。致能半导体全球首次在硅衬底上实现了垂直的GaN/AlGaN结构生长和垂直的二维电子气沟道(2DEG)。以此为基础,致能实现了全球首个具有垂直2DEG的常开器件(D-mode HEMT)和全球首个垂直常关器件(E-mode HEMT)。通过去除生长用硅衬底并在背面制作漏电极,器件实现了垂直的电极结构布局和极高的散热能力。广东致能同时展现了其领先的阈值电压调控技术,常关器件阈值电压(Vt)最高可达4V以上。作为重大原创性贡献,该工作受到了会议组委会和与会人员的高度评价并引起了广泛讨论。

广东致能CEO黎子兰博士受邀在瑞典马尔默市政厅参加答谢晚宴


广东致能CEO黎子兰博士发表邀请报告,全球首次报告垂直GaN HEMT功率器件

广东致能会上展示的垂直GaN HEMT功率器件技术
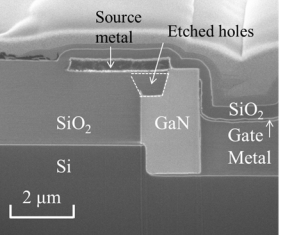

图1 x-SEM 结构 图2 剥离硅衬底
广东致能展示全球首个垂直GaN HEMT功率器件结构(如图1),此时生长用硅衬底还未被去除。如图2展示垂直HEMT晶圆,此时生长用硅衬底已被去除,观察面为原硅衬底面。


